发布时间:2025-12-30 来源:芯智讯
据韩国媒体报道,随着人工智能(AI)算力需求的爆发式成长,全球AI芯片龙头英伟达已正式要求主要的内存供应商评估在2024年第四季度交付16层堆叠的HBM4的可行性。
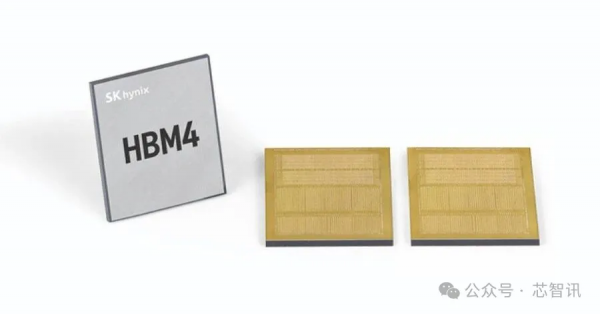
目前市场焦点仍集中在12 层堆叠HBM4 的供应商认证与量产准备上,预计12层堆叠的HBM4将于2026 年初进入全面商业化阶段。然而,英伟达显然不满足于此,希望在2026年四季度获得16层堆叠的HBM4供应。虽然,整个计划尚未签署正式合约,但已引发供应商内部的开发时程重新规划,包括良率目标与初始产量设定的动荡。
部分供应商预计,针对16层堆叠HBM4的相关的性能评估最快将于2026 年第三季前展开。根据规格与时程的最终定案,这款16 层堆叠的产品目前可能仍被归类为HBM4,或者是HBM4E的范围。
韩国半导体工业协会执行副总裁、前SK海力士高管安基贤指出,英伟达对GPU的升级非常积极,这使得HBM 也必须以相同的节奏前进。如果HBM的性能跟不上,即使是更高性能的GPU也会失去意义。
事实上,从12 层堆叠推进到16 层堆叠,其关键并非只是简单的层数堆叠而已,而是半导体封装技术的重大进步。安基贤强调,要从12 层堆叠到16 层堆叠的转换在技术上远比8 层堆叠到12 层堆叠更为艰难,许多情况下必须更换整个制程技术。
以目前的规格来分析,从12 层堆叠推进到16 层堆叠,面临的最大挑战在于封装高度与晶圆厚度上:
晶圆厚度缩薄:为了在有限的空间内堆叠更多芯片,业界估计16 层堆叠的HBM需要将从目前12 层堆叠设计的每层晶圆50微米厚度,进一步压缩至30微米左右。
封装高度限制:全球半导体标准组织联合电子器件工程委员会将HBM4 的封装高度限制在775 微米,这为传统的堆叠方法留下的空间极其有限。
以上这些物理限制使得封装键合技术成为竞争的核心。目前,三星与美光主要依赖热压键合(TCB)技术,而SK 海力士则采用其领先业界的批量回流模制底填(MR-MUF)技术。
面对16 层HBM 的挑战,各大存储巨头采取了截然不同的技术路径。
三星当前已经考虑在16 层堆叠的产品中导入“混合键合”技术。分析认为,三星之所以选择提前转向混合键合,是因为其在目前的黏合剂技术竞争中难以赶上对手,希望借此新技术实现弯道超车。近期,三星在辉达的HBM4 系统封装(SiP)测试中已获得正面的回馈。
SK 海力士虽然也正在开发混合键合作为备案,但其战略重点是尽可能延长其业界领先的MR-MUF技术的寿命。目前,SK 海力士已建立HBM4 量产框架,并开始向英伟达提供样品。
至于美光,虽然其最新进展较少被提及,但美光仍与三星同样依赖TCB 技术,并正努力在16 层堆叠的竞赛中保持竞争力。
报导强调,这场技术竞赛的关键时间点将与英伟达下一代Rubin架构GPU芯片的上市匹配,该产品预计于2026年下半年问世。据悉,每颗Rubin架构GPU将配备多达8个HBM4 堆栈,这将极大的拉动对高层数HBM 的需求。
不过,尽管业界对16 层堆叠的HBM4 充满期待,但短期内市场重心仍将稳固在HBM3E。根据市场分析师估计,HBM3E在2026 年仍将占HBM 总产量的66%,虽然较2025年的87% 有所下降,但依然是市场绝对的主流。